HOME > 徒然「光」基礎講座 > 分光エリプソメトリーとは: 1. エリプソメトリーが測定する量
分光エリプソメトリーとは: 1. エリプソメトリーが測定する量

1. エリプソメトリーが測定する量
エリプソメトリーは,電磁波の基本的な性質である「偏光」を利用した計測法です [1], [2] . エリプソメトリーでは,サンプルに入射された偏光がサンプル表面で反射する際に生じる偏光変化を観測して,薄膜の光学定数(屈折率: n ,消衰係数: κ ),膜厚: d の高感度・高精度な計測を行います. エリプソメトリーがどのような量を測定し解析しているのかを理解するために,まず,媒質界面における光の反射 / 透過について復習しましょう.
[1] R.M.A. Azzam and N.M. Bashara:"Ellipsometry and Polarized Light", North Holland Press, Amsterdam (1977).
[2] 藤原裕之:「分光エリプソメトリー 第2版」, 丸善 (2011).
図1-1 は,屈折率が異なる二つの媒質の界面における光の反射と透過の概要を示しています. 屈折率n i の入射媒質と屈折率n t の透過媒質の界面に,左上空から光が入射したとします. 入射光は,界面で入射角 θ i に等しい反射角 θ r 方向に一部反射され,残りの光が屈折角 θ t 方向に透過媒質中を透過します. 屈折角 θ t は,屈折の法則で求めることができます.
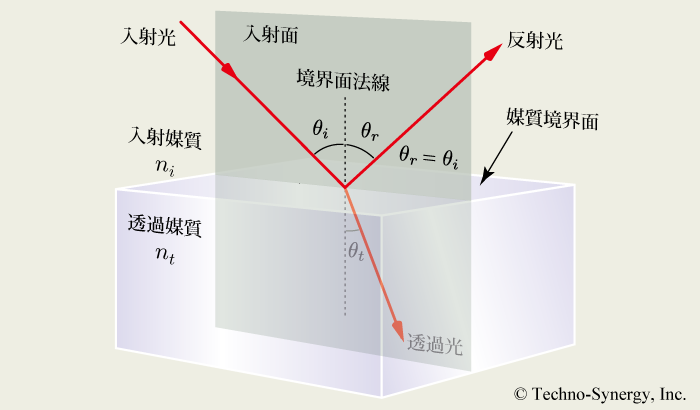
入射光と媒質界面法線を含む面を入射面と定義します. 光の電場振動面(偏光面)が入射面内にある直線偏光を p 偏光,それと直交する直線偏光を s 偏光と呼びます. p 偏光と s 偏光は反射に際して偏光状態が変わらない偏光で,全ての偏光状態は, p 偏光と s 偏光のベクトル和で表すことができます.
エリプソメトリーでは, p 偏光と s 偏光の複素振幅反射係数の比を扱うことで,シンプルで高精度な測定系を実現しています. 図1-2に,サンプル表面での光の反射とそれに伴う偏光変化のようすを示します( p 偏光, s 偏光の座標定義から,エリプソメトリーの概念図は,試料面を垂直に描くが正しい表記です).

図1-2のように,ある直線偏光を試料表面に斜入射すると, p 偏光と s 偏光とで複素振幅反射係数(振幅反射係数と反射位相)が異なるため,反射光は一般に楕円偏光となります(複素振幅反射係数は「3. 反射光と透過光の振幅」を参照). 複素振幅反射係数 r pとr s の比 ρ = r p / r s は,偏光解析関数 ( ellipsometric function ) と呼ばれ,次のように定義されます.

式から, ρ が入射光の偏光状態: E pi /E si に対する反射光の偏光状態: E pr /E sr の比で表されることが分かります. エリプソメトリーでは, ρ を極座標表示して偏光解析パラメーター Ψ , Δ を定義します. ここで, Ψ は p 偏光と s 偏光の振幅比 tan Ψ = |r p| / |r s| から求まる角度で振幅比角と呼ばれ, Δ は p 偏光と s 偏光の位相差: Δ = Δ p - Δ s と定義されます.
エリプソメトリーでは,振幅比角 Ψ と位相差 Δ を測定・解析して,膜厚や屈折率を求めます. 単一波長のエリプソメトリーで膜サンプルを測定解析する場合,予想される膜厚初期値,屈折率初期値から算出される偏光解析パラメーター: Ψsim , Δsim と,測定された Ψexp , Δ exp の誤差が十分小さくなるように振幅反射係数計算を反復して行い,薄膜の膜厚 d ,光学定数(屈折率: n ,消衰係数: κ )の収束値を求めます. ただし,二つの測定量 Ψ exp , Δ exp から三つ以上の未知数を確定することはできないため,二未知数以外を予め決定しておく必要があります. そのため,単一波長のエリプソメトリーは,主に,光学定数既知の基板上に付けられた透明一層膜サンプルに対して,膜厚 d ,屈折率 n を同時に求める精密膜厚測定に利用されます.単一波長のエリプソメトリーには,残念ながら,分光エリプソメトリーほどのサンプル適応能力は備わっていません.





