HOME > 徒然「光」基礎講座 > 分光エリプソメトリーとは: 9. 薄膜の高感度計測
分光エリプソメトリーとは: 9. 薄膜の高感度計測

9. 薄膜の高感度計測
エリプソメトリーは,一つの光を p 偏光と s 偏光の二つの波動成分に分割した干渉法で,同一光路が保証された p 偏光の波動方程式と s 偏光の波動方程式との相対的な関係である p 偏光と s 偏光の振幅比角 Ψ と位相差 Δ を測定します. そのため,別々の光路を通過した光を合成する通常の分光干渉法と比べて精度,感度ともに優れています.
図9-1 に,単結晶シリコン基板上の二酸化ケイ素膜 ( SiO2 ) の膜厚変化 ( 0 ~ 30nm ) に対する (a) 反射分光干渉法(入射角: 0° ), (b) 分光エリプソメトリー ( 入射角: 75° )のスペクトル変化シミュレーションを示します.
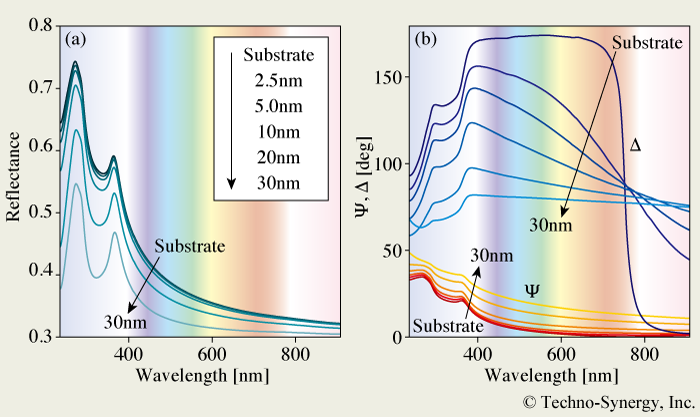
膜厚 10nm 以下の領域を比較してみましょう. 図9-1(a) 反射干渉分光法における反射率スペクトル変化は極わずかで,波長: 633nm, d = 0nm → 2.5nm の膜厚変化に対して反射率変化は 0.0003 に過ぎません. これは,一般的な分光光度計では測定が困難な変化量です.
一方.図9-1(b) 分光エリプソメトリーでは,入射角を主入射角 ( principal angle, Δ = 90° となる入射角 ) 付近に設定することで,高い測定感度を得ることができます [11] . これは,エリプソメトリーが複素振幅反射係数の比 rp / rs を測定していることに由来します. 図9-1(b) では,入射角を波長 632.8nm におけるシリコン基板の主入射角:約 75.6° に近い 75° としました. シリコン基板の Δ スペクトルを見ると, Δ = 90° をよぎる波長:約 750nm を境に,短波長側で Δ ~ 180° ,長波長側で Δ ~ 0° になっています. 基板に SiO2 膜が 2.5nm 付いた場合,基板の主入射角条件となる波長 750nm 前後で Δ の変化量が最も大きいことが分かります. 分光エリプソメトリーでは,測定波長域のどこかで基板の主入射角条件となるように入射角を設定することで,極薄膜測定における高い感度を得ることができます. そのため,膜厚が数十ナノメーターを下回る極薄膜の測定では,分光エリプソメトリーが最も優れた測定法であると言っていいでしょう.
[11] 山本正樹, 「界面ハンドブック」, エヌ・ティー・エス, pp.182-188 (2001).





