HOME > 徒然「光」基礎講座 > 分光エリプソメトリーとは: はじめに
分光エリプソメトリーとは

分光エリプソメトリーは,スペクトルが持つ豊富な情報量を活かした薄膜の光物性評価が可能で,非接触,高精度,測定が簡便などの利点から,精密な薄膜評価を必要とする様々な分野で広く利用されています. しかし,測定パラメーターの意味が分かりづらいこと,光学モデルを用いた解析が直感的に理解しづらいこと,偏光,干渉,誘電関数といった光学や光物性の基礎知識が必要なことなどから,十分に使いこなすのは容易なことではありません.
ここでは,「偏光とは?」,「なぜ分光なのか?」といった素朴な疑問にお答えいたします. 分光エリプソメトリーの基礎や原理をステップバイステップで学んでいきましょう.
はじめに
エリプソメトリーは,一つの光を p 偏光と s 偏光の二つの波動成分に分割した干渉法で,同一光路が保証された p 偏光の波動方程式と s 偏光の波動方程式との相対的な関係である p 偏光と s 偏光の振幅比角 Ψと位相差 Δ を測定します. そのため,別々の光路を通過した光を合成する通常の分光干渉法と比べて精度,感度ともに優れています.
図0-1に,単結晶シリコン基板上の二酸化ケイ素膜( SiO2 )の膜厚変化 ( 0 〜 30nm ) に対する (a) 反射分光干渉法(入射角: 0° ), (b) 分光エリプソメトリー(入射角:75°)のスペクトル変化シミュレーションを示します.
膜厚 10nm 以下の領域を比較してみましょう. 反射干渉分光法における反射率スペクトル変化は極わずかで,波長: 633nm , d = 0nm → 2.5nm の膜厚変化に対して反射率変化は 0.0003 に過ぎません.
これは,一般的な分光光度計では測定が困難な変化量です.
これに対して,分光エリプソメトリーでは,膜厚 10nm 以下の領域でも非常に大きな変化が観測されます.分光エリプソメーターが高感度な薄膜測定を得意とする理由がここにあります(「9. 薄膜の高感度計測」を参照). さあ,分光エリプソメトリーの優れた測定解析能力の秘密を一つ一つ解き明かしていきましょう.
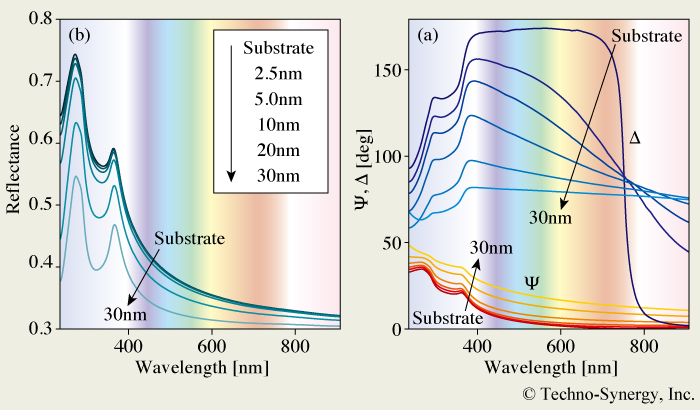
目次
- 0. はじめに
- 1. エリプソメトリーが測定する量
- 2. 偏光とは
- 3. 反射光と透過光の振幅
- 4. 薄膜中の光の伝搬
- 5. どうして分光なのか-1(分極と誘電関数)
- 6. どうして分光なのか-2(Lorentzモデル)
- 7. スペクトル解析の流れ
- 8. 分光エリプソメーター
- 9. 薄膜の高感度計測





