HOME > 徒然「光」基礎講座 > 分光エリプソメトリーとは: 7. スペクトル解析の流れ
分光エリプソメトリーとは: 7. スペクトル解析の流れ

7. スペクトル解析の流れ
分光エリプソメトリーでは, 偏光解析パラメーター Ψ, Δ の測定スペクトルと光学モデルから計算されたシミュレーションスペクトルとのフィッティングにより, 膜厚や光学定数などの物理量を求めています. そのため, 光学モデルの立て方, データ解析の進め方次第では得られる結果に違いが生ずる可能性もあります. ここでは, 「分光エリプソメトリーにおけるデータ解析の流れ」を示した図7-1 を参照しながら, 図中の番号に従って, フィッティング解析で行われる基本的な作業手順と解析を進める上で留意すべきポイントについて確認していくことにしましょう.
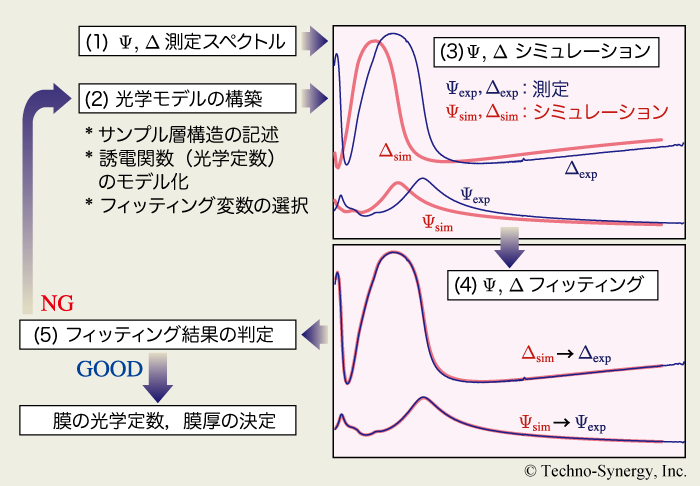
(1) Ψ, Δ 測定
分光エリプソメーターを用い, 試料の Ψ, Δ スペクトルを測定します. 被測定試料の基板には, n, k が既知のものを用いるか, n, k が未知の場合には, 試料に使用したものと同一基板の Ψ, Δ スペクトルを測定し, 以下の手順に従って予め基板の誘電関数を求めておきます.
(2) 光学モデルの構築
サンプルの層構造を記述し, 各層の誘電関数モデルを選択します. 求めたい膜の光学定数スペクトルを推測して, 誘電関数モデルの各パラメーター初期値を調整しておきます. 多くの場合, 光学定数ライブラリー, 文献値などを基に, 予想される膜の誘電関数モデルを予め作っておくことが有効です. また, 各層の膜厚初期値を決め, 光学モデルのどのパラメーターをフィッティング変数にするかを選択します.
(3) シミュレーション
作成した光学モデルからシミュレーション反射率スペクトルを生成します. 次のフィッティングを実行する前に, 測定データとシミュレーションスペクトルを見比べて, できるだけ光学モデルの各パラメーター初期値を修正しておくといいでしょう.
(4) パラメーターフィッティング
測定データとシミュレーションスペクトルのフィッティング誤差が最小になるように, 解析ソフトウエアが各パラメーター値を自動調整します. 誤差が所定の値を下回るか, 所定の計算反復回数を超えるとフィッティングは打ち切られ, 収束結果として膜の光学定数, 膜厚などの値が得られます. この時, フィッティング誤差の評価には, 一般的に次のような関数が使用されます.

(21) 式, (22) 式中の添え字 exp と sim は, それぞれ実験値と計算値を示しており, M と P は測定データ数および解析変数の数を表しています. σ を平均二乗誤差と呼びます. また,分光測定における測定誤差 δρ ( または, δΨ, δΔ ) で重み付けした次のフィッティング関数を使用する場合もあります.

χ は, 重み付け平均二乗誤差と呼ばれ, SN 比 ( signal to noise ratio ) が悪化する紫外などの波長領域を含んだフィッティング解析での誤差評価に有効です.
(5) 収束結果の評価
得られた収束結果のフィッティング誤差が大きかったり, 物理的にあり得ない場合, 局所的な極小値 (ローカルミニマム) に収束している可能性があります. もちろん, この時の収束結果は解として不適当なので, (2) に戻りシミュレーション条件を再検討する必要があります. 具体的には, 光学モデルを構築し直す (例えば, 誘電関数モデルの変更, 表面ラフネス層の追加など) , より適正な初期値を探す, フィッティングに使用するパラメーターを選択し直すなどの作業を行った後, 再度フィッティングを実行します. 納得がいく収束結果が得られるまで, (2) ~ (5) の手順を繰り返します.
フィッティング解析では, 「シンプルな光学モデルからスタートし, スペクトル変化に感度のある小数パラメーターからフィッティングを始めて, 収束状況を見ながら次第に試料の実態に合わせて光学モデルを進化させる」というのが実践的な解析の進め方といえます.





