SCOUT講座1 「コンピュータシミュレーションによる光学スペクトル分析」 (12/13)
5.3 エリプソメトリー:未知半導体の解析
図27の例では, エリプソメトリーを用いた SiO2 / Si 基板上の未知半導体膜の光学定数決定について説明します. いくつかの Tauc-Lorentz モデル項を使うことで, リーズナブルなフィッティング結果が得られました.
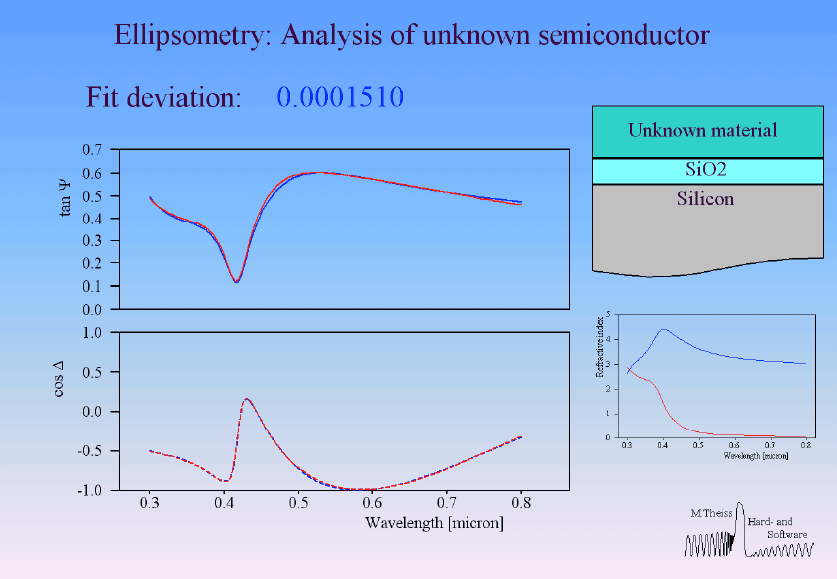 図27
図27
サンプルの表面ラフネスの代用として薄い表面層を導入することで, フィッティングを改善することができます. 表面層とは, 未知半導体膜と空気が混じり合った有効媒質層です. 表面ラフネスを導入して得られる光学定数は, 表面ラフネスなしで得られる値とさほど違いはないものの, 明らかに異なります. もしこの違いが重要な場合, 原子間力顕微鏡 ( AFM: Atomic fouce microscope ) などの別手段で, 表面ラフネスが存在するという仮定を検証するべきでしょう.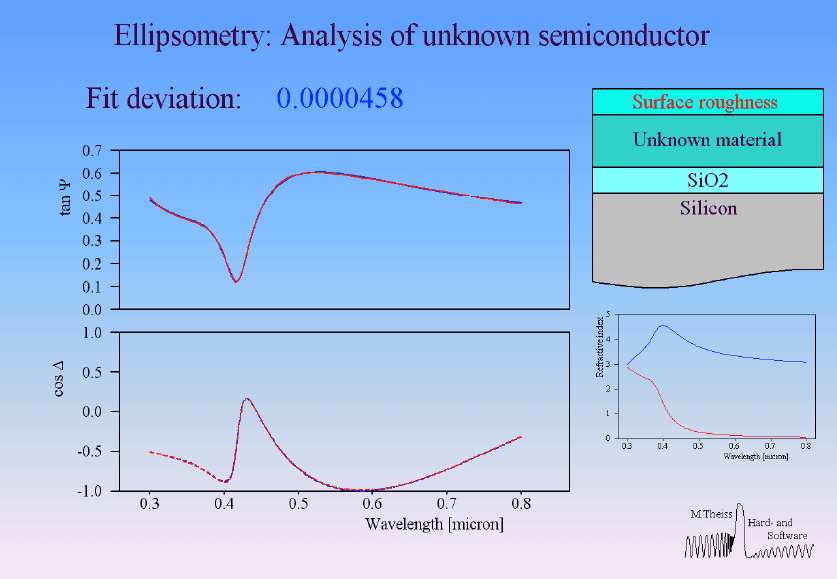 図28
図28
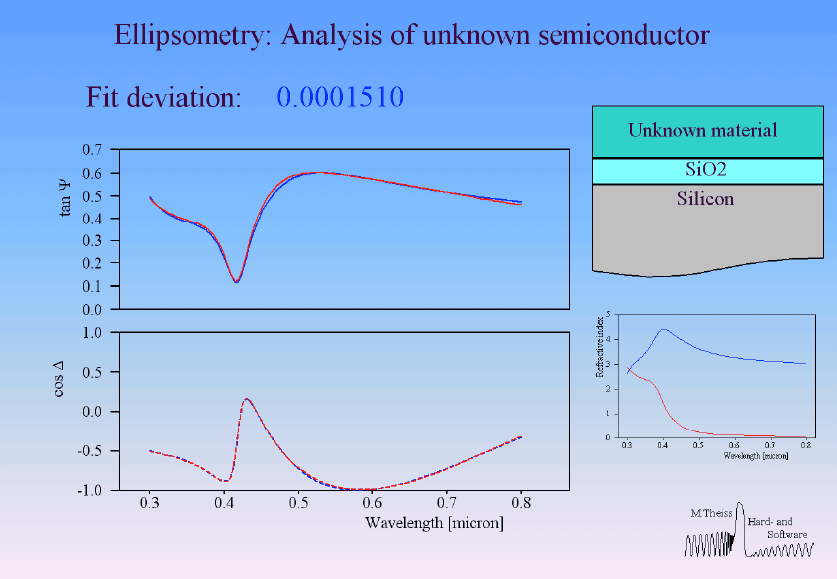 図27
図27サンプルの表面ラフネスの代用として薄い表面層を導入することで, フィッティングを改善することができます. 表面層とは, 未知半導体膜と空気が混じり合った有効媒質層です. 表面ラフネスを導入して得られる光学定数は, 表面ラフネスなしで得られる値とさほど違いはないものの, 明らかに異なります. もしこの違いが重要な場合, 原子間力顕微鏡 ( AFM: Atomic fouce microscope ) などの別手段で, 表面ラフネスが存在するという仮定を検証するべきでしょう.
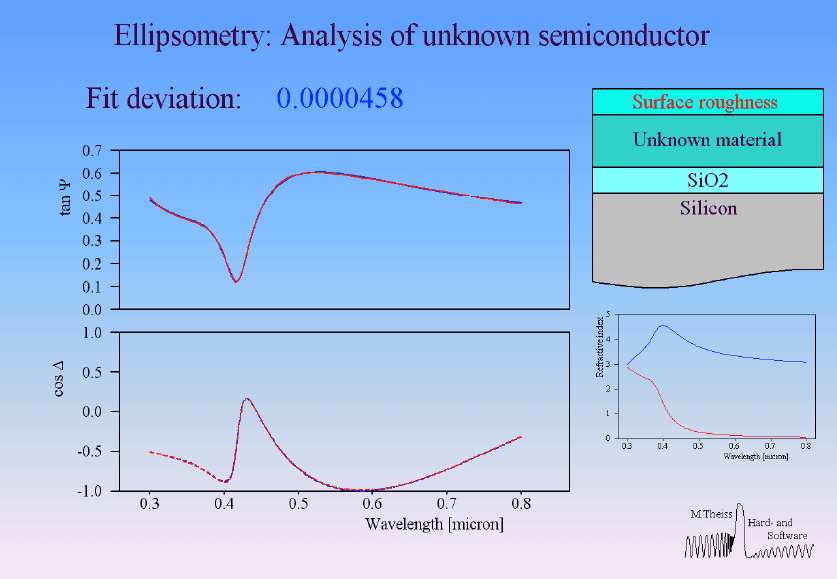 図28
図285.4 複数スペクトルの同時解析
得られるパラメーター収束値の信頼性を向上するために, より重要なスペクトル情報をもたらすかも知れない 2 つ以上のスペクトルを同時に解析することができます. 以下, いくつかの「複数スペクトル同時解析」の例を示します.
ガラス基板のような透明基板の場合, 反射および透過測定を行い, 両方のスペクトルを同時に解析することが可能です. 図29に示す例では, 表面ラフネスを持つ CdS 層の厚さを決定しています.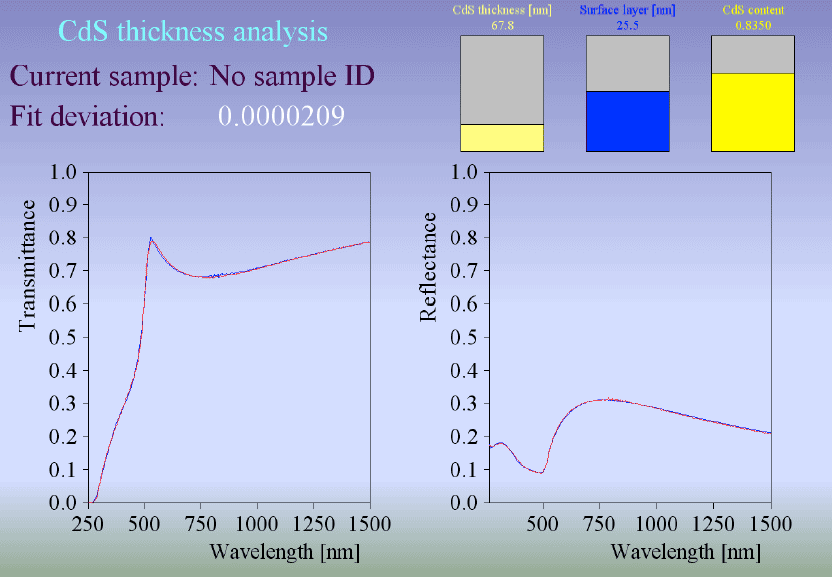 図29
図29
ガラス基板のような透明基板の場合, 反射および透過測定を行い, 両方のスペクトルを同時に解析することが可能です. 図29に示す例では, 表面ラフネスを持つ CdS 層の厚さを決定しています.
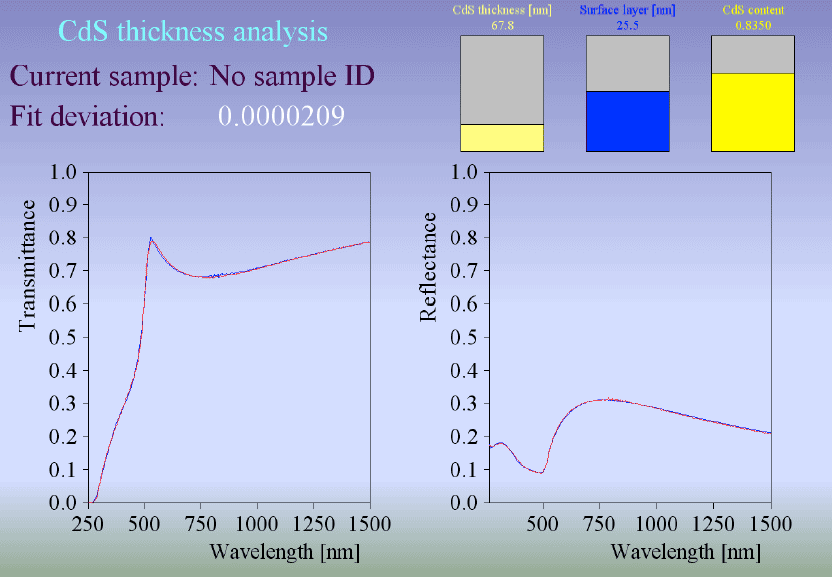 図29
図29


